 |
美國Microchem公司於2019年8月底正式更名為Kayaku Advanced Materials, Inc.。 Kayaku AM的SU-8 光阻是一種負膠,適合 i 線,X-Ray,E-beam曝光。具有非常好的熱穩定性、抗蝕刻性、高解析度、高深寬等特性。對近紫外線350~400nm波段曝光最為敏感。即使在非常厚的光阻曝光情況下,曝光均勻一致,可以獲得垂直邊壁。
日本化藥(Nippon Kayaku)擁有近百年歷史,是環氧樹脂產業的領導者。側壁陡直,機械性,絕緣性及耐溫性能等SU-8無可比擬的優點,也正是得益於日本化藥的支持。 2008年起,Microchem併入日本化藥旗下,並與日本化藥共同開發出KMPR以及SU-8 3000系列等新產品。 |
環氧樹脂型永久光阻
|
|||||||
|
KMPR® 1000 系列 - 暫時/永久性高深寬比負膠
KMPR用作DRIE蝕刻遮罩實現高寬比的圖案。它也被廣泛用作MEMS與生物裝置的電鍍模具。因KMPR減少了Cross-link密度,在Hard baked 前,KMPR比較SU-8容易剝離。 KMPR負膠可在任何(PGMEA),或(TMAH)的顯影劑中顯影。
|
|
聚合物型永久光阻
|
臨時 Lift Off 光阻
|
臨時 Lift Off 光刻膠
|
|
UniLOR® N單層Lift-off專用光阻
|
電子束正型光阻
|
臨時電鍍光阻
新! TempKoat™ P 20 - 臨時性厚膜正膠
• 用於電鍍應用的厚膠
• 膜厚10μm - 40μm • 相容於Microbump及RDL電鍍液 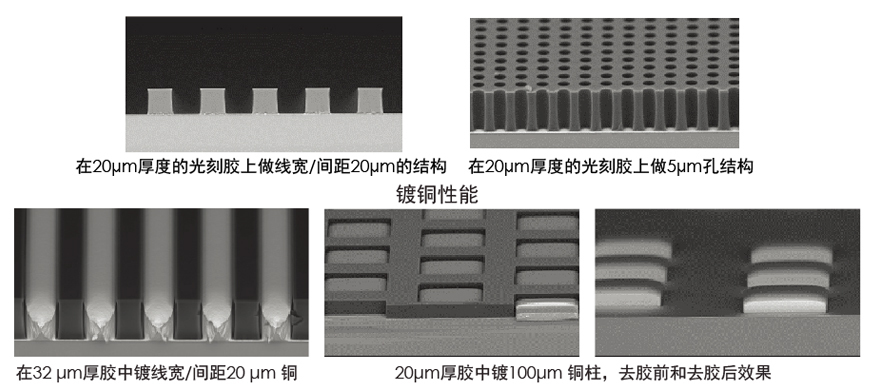 光阻 - 厚膠旋塗工藝
在銅基板上旋塗32 μm厚度的膠
前烘: 120˚C, 5 分鐘 曝光: 650 mJ/cm2 ABM 掩膜對準光刻機,360nm長通濾波片,在365nm處測得強度 後烘: 75˚C, 2 minutes 顯影: 0.26N TMAH 5 x 1分鐘旋覆浸沒式 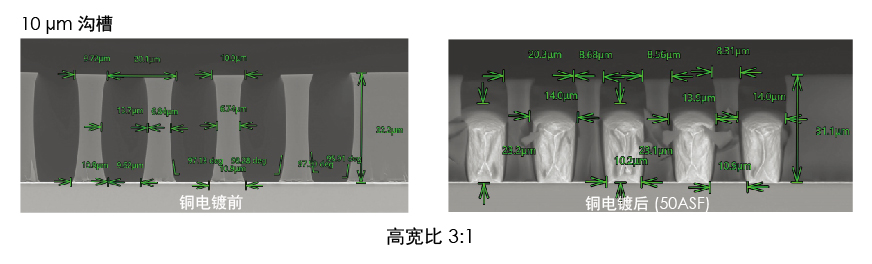 |